IoTや5G、AIなどの普及により、高性能な半導体の需要が急増しています。微細化による高集積化は技術・コスト面で限界に近づいており、2.5Dや3Dなどの先端半導体パッケージ技術が注目されています。当社は、先端半導体パッケージ用の各種熱処理装置をご用意し、次世代半導体の製造に貢献してまいります。
先端半導体パッケージとは
先端半導体パッケージとは、異なる機能を持つ複数の半導体チップを一つのパッケージ内に収めたもので、複数のチップ(チップレット)を高密度に実装した半導体製品を指します。これらは2.5D-ICや3D-ICと呼ばれます。各チップが別々のパッケージに搭載されるよりも、チップ間の距離が短くなるため、情報伝達速度が向上します。また、複数の機能を持たせた一つの大きなチップを作るよりも、異なる機能を持つチップを組み合わせる方がコスト削減、歩留まり改善、生産性の向上につながります。
従来、半導体の製造工程においては、ファウンドリーが前工程、OSATが後工程を担当するというように分業されていました。しかし、先端半導体パッケージの製造においては、前工程と後工程それぞれの技術が活用できるため、いずれの分野からも参入が進んでいます。
高性能を持つ先端半導体パッケージ技術は、AIや高性能コンピューティング、5G通信、スマートフォン、IoTデバイス、自動運転など、様々な分野や製品で利用されています。
-

AI
-

5G通信
-
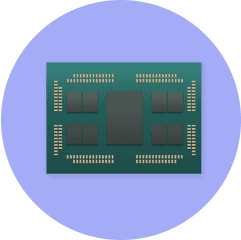
先端半導体
パッケージ -

携帯電話
-

自動運動
先端半導体パッケージ対応熱処理プロセス
プリント基板(PCB)の乾燥や、Siインターポーザ・RDL(再配線層)・ガラスインターポーザなどの各種熱処理の他、はんだバンプ形成後のリフロー、 チップモールド後の焼成などに対応しています。また、FO-WLP(Fan Out-Wafer Level Package)・WL-CSP(Wafer Level-Chip Size Package)用熱処理装置にも豊富な納入実績がございます。
当社では、これまでに半導体製造装置や液晶基板用装置の製造で培った経験・技術を生かし、先端半導体パッケージの各種製造工程に対応した装置を供給しています。
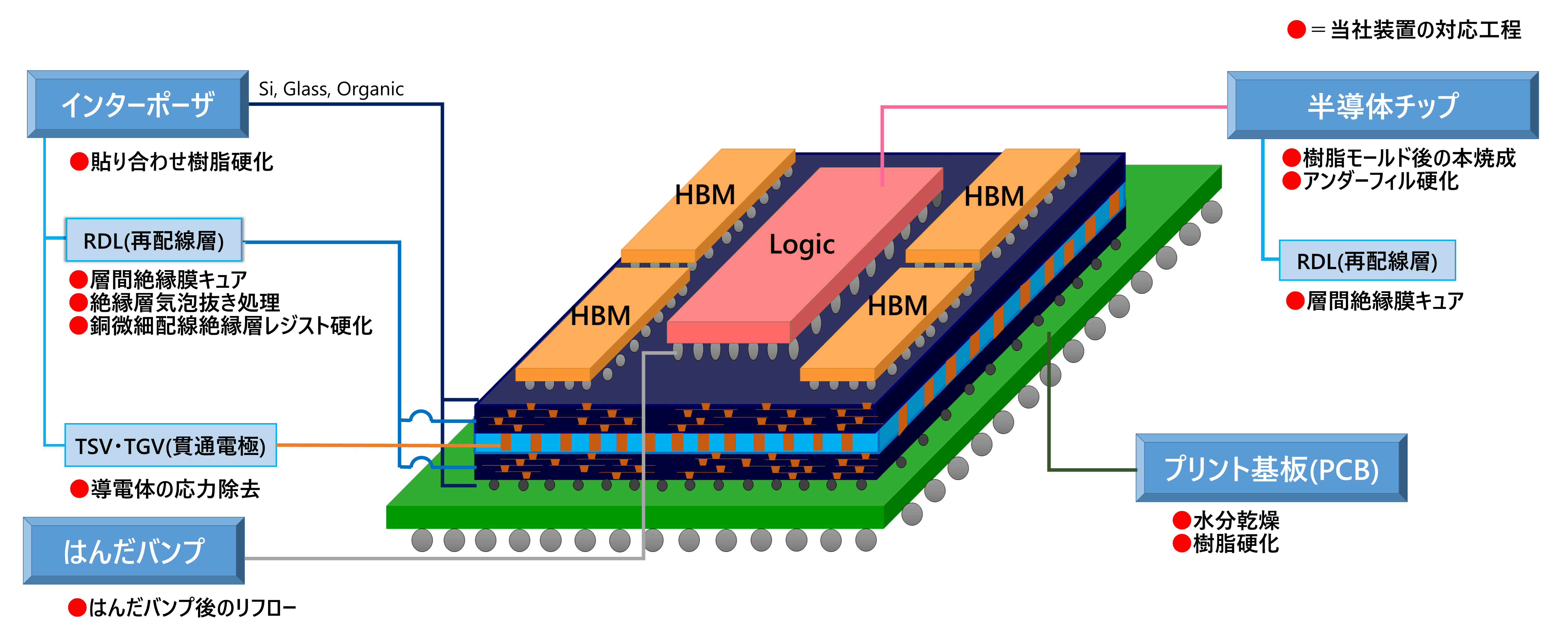
製品ラインアップ
| 装置型式 | 量産用 | 研究開発用 | ||||
|---|---|---|---|---|---|---|
| クリーンオーブン | 縦型炉 | 大口径縦型システム | クリーンオーブン | |||
| SO2-30L-F | SO2-60-F | VF-5700B-F2VF-5900B | VFS-4000 | CLH-21CD (H) CLH-35CD (H) |
||
| FO-WLP | ○ | ー | ー | ○ | ー | ○ |
| FO-PLP | ー | ○ | ○ | ー | ○ | ○ |
| Siインターポーザ | ○ | ○ | ー | ○ | ー | ○ |
| ガラスインターポーザ | ○ 丸ウェーハ形状のみ対応 |
○ 角形基板対応 |
○ 角形基板対応 |
○ 丸ウェーハ形状のみ対応 |
○ 角形基板対応 |
○ 角形基板対応 |
| 有機インターポーザ | ○ 丸ウェーハ形状のみ対応 |
○ 角形基板対応 |
○ 角形基板対応 |
○ 丸ウェーハ形状のみ対応 |
○ 角形基板対応 |
○ 角形基板対応 |
| 対応基板サイズ (mm) |
310x310 (300x300) |
510x515 600x600 |
310x310 (300x300) 510x515600x600 |
310x310 (300x300) |
||
| チャンバ数 | 2 | 2 | 2 | 1 | 1 | 1 |
| 最大処理枚数*¹/チャンバ | 50枚*²、52枚*³ | 26枚 | 24枚 | 75枚*⁴、100枚*⁵ | 12枚 | ー |
| 加熱方式 | 熱風循環式 | 抵抗加熱式 | 熱風循環式 | |||
| 基板搬送 | ロボット搬送 | 手動 | ||||
| I/Oポート数 (FOUP) | 4 | 4 | 4 | 2 | 2 | ー |
| 使用温度範囲 | 70~450℃*² 70~400℃*³ |
70~400℃ |
70~350℃ 70~400℃*6 |
~750℃ | ~600℃ | RT+70~530℃ |
| 残留酸素濃度 | 10ppm以下 | 20ppm以下 | ||||
| セルフクリーニング | ー | ー | ー | 高温バーンアウト | ー | |
- *¹ 基板厚みや反りにより、処理枚数は増減することがあります。
- *² SO2-12-Fの場合
- *³ SO2-12L-Fの場合
- *⁴ VF-5700B-F2の場合
- *⁵ VF-5900Bの場合
- *6 オプション対応